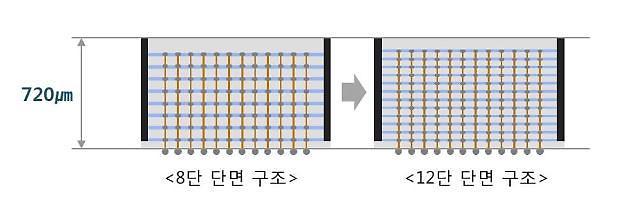
[サムスン電子、業界初「12段3D-TSV」開発…"パッケージング分野でも超格差"]
サムスン電子が業界で初めて「12段3D-TSV(3次元シリコン貫通電極・3D Through Silicon Via)」技術を開発したと7日、明らかにした。
12段3D-TSVは従来のワイヤを利用してチップを連結する代わりに、半導体チップの上段と下段に髪の毛の太さの20分の1水準である数マイクロミトの直径の電子移動通路(TSV)6万つを作り、誤差なく連結する先端パッケージング技術である。
この技術は紙(100㎛)の半分以下の厚さで加工したDラムチップ12つを積層して垂直に連結する高度の精密性が必要である。 3D-TSVは従来のワイヤボンディング(Wire Bonding)技術より、チップ間の信号をやり取りする時間が短く、速度と消費電力を画期的に改善できる点が特徴だ。
サムスン電子は従来の8段積層のHBM2製品と同一のパッケージの厚さ(720㎛、業界標準)を維持しながらも、12つのDラムチップを積層して顧客たちは別途のシステムデザインの変更なく、より高い性能の次世代高容量製品を発売できるようになった。
また、高帯域幅のメモリに「12段3D-TSV」技術を適用し、従来の8段から12段に高めることにより、容量を1.5倍増加させることができる。
この技術に最新の16Gb Dラムチップを適用すれば、業界最大容量の24GB HBM(高帯域幅メモリ・High Bandwidth Memory)製品も具現できる。 これは現在、主力で量産中の8段8GB製品より3倍増えた容量だ。
サムスン電子は顧客の需要に合わせ、12段3D-TSV技術を適用した高容量HBM製品を適時に供給し、プレミアム半導体市場を持続先導していく計画だ。
<亜洲日報の記事等を無断で複製、公衆送信 、翻案、配布することは禁じられています。>
